會(huì )議簡(jiǎn)介:ISPSD(全稱(chēng)為:IEEE International Symposium on Power Semiconductor Devices and ICs, 功率半導體器件和集成電路國際會(huì )議)是功率半導體器件和集成電路領(lǐng)域在國際上最重要、影響力最強的頂級學(xué)術(shù)會(huì )議,它被認為是功率半導體器件和集成電路領(lǐng)域的奧林匹克會(huì )議,一直以來(lái)都是國內外半導體產(chǎn)業(yè)界龍頭企業(yè)(臺積電、三星、松下,英飛凌,東芝等)和全球知名學(xué)術(shù)科研機構(歐洲微電子中心、香港大學(xué),香港科技大學(xué),北京大學(xué),電子科大,名古屋大學(xué),多倫多大學(xué)等)爭相發(fā)表和展示功率半導體前沿技術(shù)重要成果的舞臺。
氮化鎵(GaN)作為一種寬禁帶半導體,是第三代半導體的典型代表。與第一代半導體硅(Si)基的器件相比,GaN器件由于具有更高耐壓,更快的開(kāi)關(guān)頻率,更小導通電阻等諸多優(yōu)異的特性,使得其在功率電子器件領(lǐng)域可以得到廣泛的應用,從低功率段的消費電子領(lǐng)域,到中功率段的汽車(chē)電子領(lǐng)域,以及高功率段的工業(yè)電子領(lǐng)域均將有著(zhù)極其重要的應用。根據國際權威調研機構Yole統計,GaN器件可以適用于68%的功率器件市場(chǎng)。同時(shí),在功率轉換電路中應用GaN器件可以消除整流器在進(jìn)行交直流轉換時(shí)90%的能量損失,極大的提高能源利用效率,還可以使筆記本等電源適配器的體積最多縮小80%,極大地減小設備體積提高集成度。

圖1. GaN HEMT 電力電子器件的應用
在實(shí)際的應用中,為了實(shí)現失效安全的增強模式(E-mode)操作,人們廣泛研究了基于凹槽柵結構的MIS柵和p-GaNregrowth柵增強型GaN HEMT器件。在實(shí)際的器件制備過(guò)程中精確的控制柵極凹槽刻蝕深度以及減小凹槽界面態(tài)密度將直接影響著(zhù)器件的閾值電壓均勻性和柵極可靠性,尤其是在大規模量產(chǎn)中會(huì )直接影響器件的量產(chǎn)良率。然而,到目前為止,利用現有技術(shù)手段無(wú)法同時(shí)解決這兩大問(wèn)題。
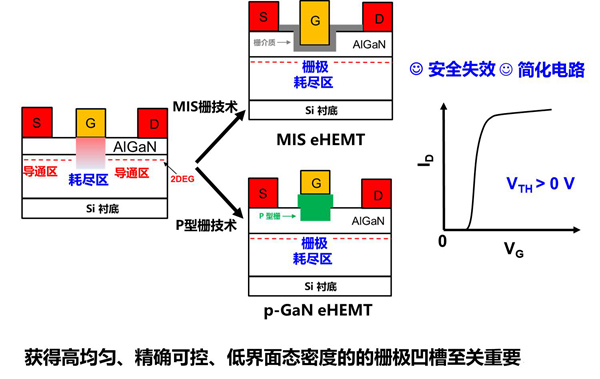
圖2. GaN HEMT 增強型器件技術(shù)路線(xiàn)及關(guān)鍵科學(xué)問(wèn)題
基于以上研究背景及在科研界產(chǎn)業(yè)界亟待解決的關(guān)鍵問(wèn)題基礎上,在中科院蘇州納米所孫錢(qián)研究團隊在讀博士研究生生蘇帥和鐘耀宗及其他團隊成員的合作攻關(guān)下,經(jīng)過(guò)近三年時(shí)間的不懈努力,繼先后在p-GaN Regrowth器件制備技術(shù)及器件可靠性測試分析技術(shù)等核心技術(shù)上取得突破,相關(guān)論文先后發(fā)表于國際權威電子器件領(lǐng)域期刊IEEE Electron Device Letters vol. 40, no. 9, pp. 1495-1498, Sept. 2019,ACS Applied Materials & Interfaces vol. 11, no. 24, pp. 21982-21987, May. 2019,IEEE Journal of Emerging and Selected Topics in Power Electronics, 2020, doi: 10.1109/JESTPE.2020.3014372.上,且成功制備的器件閾值電壓達到~1.7 V@ IDS = 10 μA/mm,開(kāi)關(guān)比達到5×1010,輸出電流400mA/mm以上,器件綜合性能達到國際一流水平。在上述研究工作基礎上,團隊又于近期在將外延技術(shù)與器件加工工藝緊密結合基礎上,利用創(chuàng )新型的技術(shù)手段在柵極凹槽深度高均勻性的精確控制及減小凹槽界面態(tài)密度方面取得重要進(jìn)展,利用自主創(chuàng )新的MOCVD熱分解自終止技術(shù)手段實(shí)現了精確可控的柵極凹槽制備,且凹槽深度均勻性大幅提高,同時(shí)柵極界面態(tài)密度減小1~2個(gè)數量級,達到 ~1011 eV-1·cm-2 ,為研制高性能MIS及pGaN柵極增強型器件的研發(fā)及量產(chǎn)奠定了基礎。該工作已發(fā)表于第三十二屆功率半導體器件和集成電路國際會(huì )議(Shuai Su, Yaozong Zhong, et al., "Self-terminated Gate Recessing with a Low Density of Interface States and High Uniformity for Enhancement-mode GaN HEMTs," 2020 32nd International Symposium on Power Semiconductor Devices and ICs (ISPSD), Vienna, Austria, 2020, pp. 333-336, doi: 10.1109/ISPSD46842.2020.9170199.)。
會(huì )議期間,該工作引起了此次會(huì )議主席、GaN功率器件研究領(lǐng)域權威人物英飛凌公司首席技術(shù)官Oliver Haberlen博士的濃厚興趣和高度稱(chēng)贊。此技術(shù)的開(kāi)發(fā)不僅僅適用于GaN HEMT器件的制備,同時(shí)也適用于基于GaN材料體系的其他器件的制備,以便獲得高度均勻的凹槽深度和極低的界面態(tài)密度,結合本團隊已有p-GaN Regrowth器件制備技術(shù)將能夠極大提高制備器件的均勻性和可靠性,有望在器件大規模量產(chǎn)中大幅提高器件的生產(chǎn)良率。該技術(shù)已申請國家發(fā)明專(zhuān)利(201910388910.4),并將通過(guò)PCT國際專(zhuān)利(PCT/CN2019/130362)進(jìn)入美國、加拿大、日本、德國等。

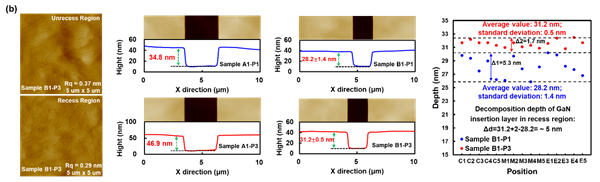
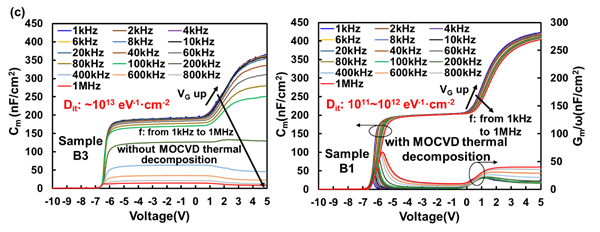
圖3. (a)MOCVD熱分解實(shí)現高均勻性低界面態(tài)柵極凹槽結構的技術(shù)路線(xiàn);(b)基于MOCVD熱分解制備的凹槽的表面形貌,熱分解自終止的驗證及片上均勻性統計;(c)利用變頻CV表征柵極界面態(tài)密度。
上述相關(guān)工作的主要作者為中科院蘇州納米所在讀博士研究生蘇帥和鐘耀宗,通訊作者為孫錢(qián)研究員和周宇副研究員。上述工作得到了國家自然科學(xué)重點(diǎn)基金項目、國家重點(diǎn)研發(fā)計劃課題、中國科學(xué)院重點(diǎn)前沿科學(xué)研究計劃、江蘇省重點(diǎn)研發(fā)計劃項目等資助。